|
|
 |
如何著手分析市場返修的電子不良品及BGA不良

這個【如何著手分析市場返修的電子不良品及BGA不良】題目應該只是一個普通的邏輯問題,不過工作熊卻發現有很多新手工程師在接到客戶或市場上退回來的不良品時卻根本不知道如何下手。工作熊最近發現公司內有些新進人員,甚至會直接破壞現場,只能搖頭!
其實分析不良品真的就像CSI或NSCI影集一樣,得應用科學方法抽絲剝繭,一步一步慢慢的把真相解開,要先收集(觀察)證據,判斷收集犯罪的可能原因,好像有點太投入影集了,應該是假設各種可能原因,然後逐步驗證,最後找出真因,如果可以的話,最好還要可以複製真因。
老實說,所有工程問題的解決手法都與【8D report】及【Problem Solving】 類似,重點就是如何按部就班,一步一步執行而已,有時候看似枯燥,但按部就班往往可以避免掉一些不小心遺落的小細節,甚至可能從中獲得一些意外的收穫,所謂魔鬼藏在細節裡。
類似,重點就是如何按部就班,一步一步執行而已,有時候看似枯燥,但按部就班往往可以避免掉一些不小心遺落的小細節,甚至可能從中獲得一些意外的收穫,所謂魔鬼藏在細節裡。
解工程問題本來就是在比細心,而這似乎也是台灣工程師的強項,這與研發時的天馬行空創造不同,不過大部分台灣RD做的工作不像研發,而比較像精實設計,就是拿人家設計好的產品去蕪存菁,難聽點就是做產品的cost-down版本。
外觀檢查》非破壞性測試》局部破壞性測試》破壞性測試
分析不良品時,原則上要先做整體外觀檢查,接著才做非破壞性測試,如果無法發現問題,接著做局部破壞測試,還發現不了問題,最後才做破壞性測試。
下面這些是工作熊個人分析不良品的一些步驟與心得,因為只是憑著自己的記憶及經驗來整理,所以可能會有些遺落或缺失的地方,有看到不足的朋友,還請提點一二:
1. 如果是整機未拆的機器,可以先進行外觀檢查與功能(Function)測試以確認產品是否真的是不良品
有時候客戶退回來的產品根本就是良品被誤判(false reject, No Deect Found)而已,產品本身可能並沒有問題,也有可能是客戶的電源供應器有問題或其他問題所造成,與產品本身並沒有關係。
不過有些產品的不良現象必須要開機一段時間後才會顯現,有些則是間歇性出現,這時候最好的方法就是開機讓自動程式跑個最少24H,並做一些基本操作,來看看能否可以重現/複製客戶問題。
最好還可以在拿到不良品前就先詢問客戶是在什麼情況下及什麼環境下發生的不良,這樣比較能夠掌握狀況,判斷可能不良的原因。
另外,建議一定要檢查一下外觀有無從高處掉落撞擊的痕跡,因為有些不良的原因是因為撞擊而損壞內部零件。
2. 如果拿到的不良品已經被拆機或只有電路板,建議先做電路板的外觀檢查
有些返修品可能是因為外物(個人曾經在機器內看過蟑螂或是蜘蛛結網的,因為機器會發熱,潮濕又溫暖,很適合某些昆蟲居住)、或是液體不小心沾污(最常看到的是可樂、咖啡這類飲料)所造成的短路問題,另外有些不良品也會因為某些原因而造成短路燒毀零件或是電路,這些都可以從外觀上大致看出來。
建議要使用顯微鏡來觀察電路板上電路及零件狀況,要做整機及整片板子的地毯式檢查,不要放過任何的蛛絲馬跡。
3. 電路板檢查過外觀後,要再做一次電性測試,而且要量測CPU溫度
如果客戶只退回電路板,做過外觀檢查後再對電路板做電性測試(Function Test)是一定要的,理由同第1點。但即使客戶退回的是整機,也可以在個別的電路板上做電性測試,以判斷是那一片電路板有問題,因為有些機器內可能是好幾片板子組成的,這樣可以做初步排除查。
另外,針對那些開機一段時間後才會出現不良的電路板,可以試著用溫度計來量測主要元件(如CPU)的溫度是否正常,如果有溫度異常升高則表示電路上可能有問題,其實如果溫度沒有升高也可以初步判斷CPU有無動作。
4. 進行電路信號量測,以確認不良零件及位置
當我們無法由外觀及基本的電性測試來判斷不良的原因時,就要開始做更深入的分析,這時候通常可以看到電子工程師拿著三用電表及示波器在那裡左戳右量,查看哪一條線路沒有導通或短路,還是那個電壓不對了,或是IC零件間timing的配合出了問題,總之就是要找出可能是那個零件的哪幾個點可能有問題。
這裡也是工作熊的弱項,因為工作熊是機械背景,所以就先Bypass了。
5. 如果經過電性量測後,判斷是BGA出了問題
最好可以知道BGA不良是短路(short)還是開路(open),而且還要指出有問題的可能焊點位置,相信電子工程師有這個能力才對。
5.1 如果是BGA短路
直接拿去照X-Ray大概就可以知道是怎麼一回事了,不過如果是市場退回的不良品,BGA短路的機率應該不高才是,因為出廠前已經做過並通過了基本的電性測試。
要留意的是,有些短路問題,即使照X-Ray也不一定可以看到問題,這時候可能需要檢查看看是否因為助焊劑(flux)殘留及濕氣(moisture)所造成的微斷路問題,一般這種現象只會出現在環境測試(environmental test)的條件下,也就是高溫高溫的環境下,一般真正客戶退回來因為助焊劑而造成的問題其實不多,但也不能排除就是了,尤其是比較細間距的BGA。
其次,也不排除有CAF板內微短路問題,CAF會出現在相鄰電路過接近,尤其是在via或PTH與電路(trace)間有偏壓(bias voltage)時,造成電子遷移現象的短路。
5.2 如果是BGA開路,則會有好幾種可能了:
5.2.1 IC封裝內的bonding wire斷掉或是bonding wedge脫落,可使用X-Ray就可以判斷出來。
5.2.2 BGA錫球的焊點開路。要先收斂問題點是在哪個錫球的焊點出問題,然後用X-Ray來查看,只是一般空焊或是斷頭的焊點很難用2D的X-Ray看得出來,建議要使用【3D X-ray CT】並確認有問題的焊點(球),【2D X-Ray】的話要選擇可以傾斜角度的設備,否則就自己墊東西做傾斜,勉強可以看。
如果有問題的地方是在BGA外圍的錫球,則可以考慮使用光學顯微鏡或蛇管(glass fiber)之類的光學方法查看,如果沒有其他零件檔住,一般可以直接看到最外圍兩排的BGA錫球,而且最容易發生「枕頭效應(HIP)」的地方也大部分多落在BGA外圍的錫球附近,這是因為電路板與BGA載板容易在過回流焊時發生板彎的關係。只是最終結果都是令人失望的,因為看不到問題。
相關閱讀:如何由X-Ray來判斷BGA有否空焊
5.2.3 如果以上方法都找不到答案,最後才考慮使用紅墨水試驗(Red Dye Penetration)或切片(Cross-section)的方法。
要先強調,這兩種方法最好委託有經驗的人員來製作及分析,因為這兩項都屬於永久性的破壞試驗,所以應該被安排到最後一個步驟才執行。
如果你的不良品只有一片,個人會建議直接做切片,因為切片比較精細,也比較能夠看到問題,而且還有機會同時看到BGA焊點與PCB結構的問題,因為開路不只會發生在BGA焊點,也可能出現在PCB內部堆疊的卯接點。製作切片時一定要把有問題的PCBA切下來才能做分析,所以一定要確切的指出是哪顆BGA有問題,最好也能指出是BGA的那個焊點,這樣比較能節省時間,因為製做切片的時候可是非常耗費時間的,如果時間不是問題或是真的無法事先確認有問題的錫球時,則可以一排一排BGA的錫球切下去觀察,這樣雖然花時間,也花金錢(實驗室是依照時間收錢的),但是比較能看到問題點,記得要有耐心,因為可能一次要觀察好幾十顆甚至好幾百顆的錫球,看多了總有眼花的時候,因為容易出錯,所以不能急,最好可以有兩個人同時確認。
如果你有好幾片相同不良現象的電路板可以做分析,才來考慮紅墨水測試,因為紅墨水屬於比較粗糙的破壞分析法,而且只能看出焊點有沒有裂縫及HIP之類的不良,而且如何判斷也是一門學問,不過如果是大面積的焊點不良,紅墨水倒不失為一個有效的方法,因為一次可以同時看遍整顆BGA的所有焊點。
相關閱讀:
BGA錫球缺點的幾種檢查方法
用滲透染紅試驗 (Red Dye Penetration Test)查看BGA焊錫
延伸閱讀:
零件掉落與鍍金厚度的關係
BGA枕頭效應(head-in-pillow)發生的可能原因
台灣電路板協會(TPCA)-學習焊錫及電路板知識的好地方
|
|
訪客留言內容(Comments)
訪客留言注意事項:
1.首次留言須通過審核後內容才會出現在版面上,請不要重覆留言。
2.留言時請在相關主題文章下留言,與主題不相關的留言將會被視為垃圾留言,請善加利用【搜尋框】尋找相關文章,找不到主題時請在「水平選單」的「留言板」留言。
3. 留言前請先用【搜尋框】尋找相關文章,自己做一點功課後再留言。沒有前因後果的內容,工作熊不一定會瞭解你在說什麼,就更無法回答你的問題。
4. 工作熊並非某一方面的專家,所以回答的內容或許會有不正確的地方,服用前還請三思。如果您想詢問關於電路板方面的工程問題,請前先參考這篇文章【詢問工程問題,請提供足夠的資訊以利有效回答】 把自己的問題想清楚了再來詢問,並且請提供足夠的資訊,這樣才能有效回答問題。
5. 工作熊每則留言都會看,但不會每則留言都回答,尤其是只有問候之類的內容。
6. 留言詢問時請注意您的態度,工作熊不是你的「細漢」,更沒有拿你的薪水,所以不接受吆喝工作熊的態度來回答你的問題。
7. 原則上工作熊不接受私下電子郵件、電話、私訊、微信或任何即時通聯絡。
8. 自2021年7月起Google將停止最新文章電子郵件通知,如果你想隨時接收部落格的最新文章可以參考這裡。
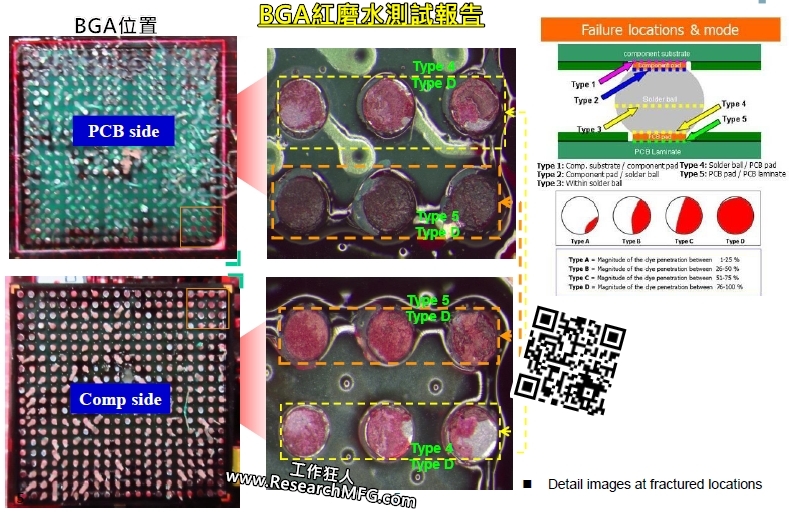





看多了總有演花得時候。> 更正錯字>是眼花